การสลักเวเฟอร์มีวิธีการอะไรบ้าง?
การตัดแผ่นเวเฟอร์หมายถึงกระบวนการตัดแผ่นเวเฟอร์แผ่นเดียวให้เป็นชิปอิสระหลายแผ่น ("ได") กระบวนการนี้ดำเนินการหลังจากกระบวนการผลิตเซมิคอนดักเตอร์ทั้งหมดเสร็จสิ้นบนแผ่นเวเฟอร์เพื่อการบรรจุและการทดสอบในภายหลัง มีหลายวิธีในการตัด และวันนี้เราจะแนะนำวิธีดังกล่าวอย่างเป็นระบบ
ทำไมจึงมีกระบวนการจารึก?
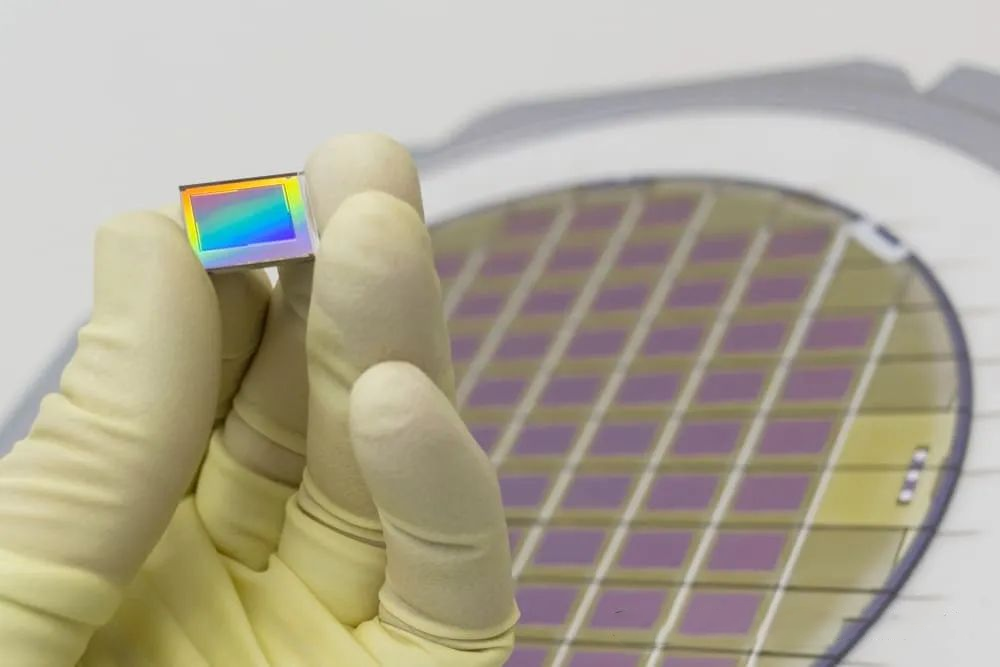
เวเฟอร์ประกอบด้วยชิปหลายพันชิ้น โดยชิปแต่ละตัวจะเป็นหน่วยอิสระ เมื่อการผลิตชิปเสร็จสิ้น ชิปจะอยู่ในสถานะรั่วไหลเปล่า และการกัดกร่อนทางเคมี ฝุ่น ความชื้น และอื่นๆ ในสภาพแวดล้อมของเทอร์มินัลจะทำให้ชิปได้รับความเสียหายร้ายแรง ดังนั้นชิปจึงต้องสวม "เสื้อผ้า" (เปลือก) เพื่อปกป้องชิป นั่นคือการบรรจุภัณฑ์ กระบวนการเขียนช่วยให้สามารถบรรจุชิปแต่ละตัวได้ทีละชิ้นเพื่อใช้ในสภาพแวดล้อมของเทอร์มินัล
วิธีการที่โดดเด่นในการสไลซ์คืออะไร?
โดยทั่วไปจะมีการขีดเขียนด้วยกลไก การขีดเขียนด้วยเลเซอร์ การขีดเขียนด้วยเลเซอร์สามารถแบ่งได้เป็นการตัดแบบซ่อนด้วยเลเซอร์และการตัดแบบเลเซอร์ทั้งหมด โดยจะมีเส้นทางการตัดที่ตัดกันบนเวเฟอร์ และเส้นทางการตัดจะต้องตัดตามขอบเขตของชิปแต่ละชิ้น ซึ่งโดยทั่วไปจะถูกหั่นตามเส้นทางการตัด
การขีดเขียนด้วยเครื่องจักร
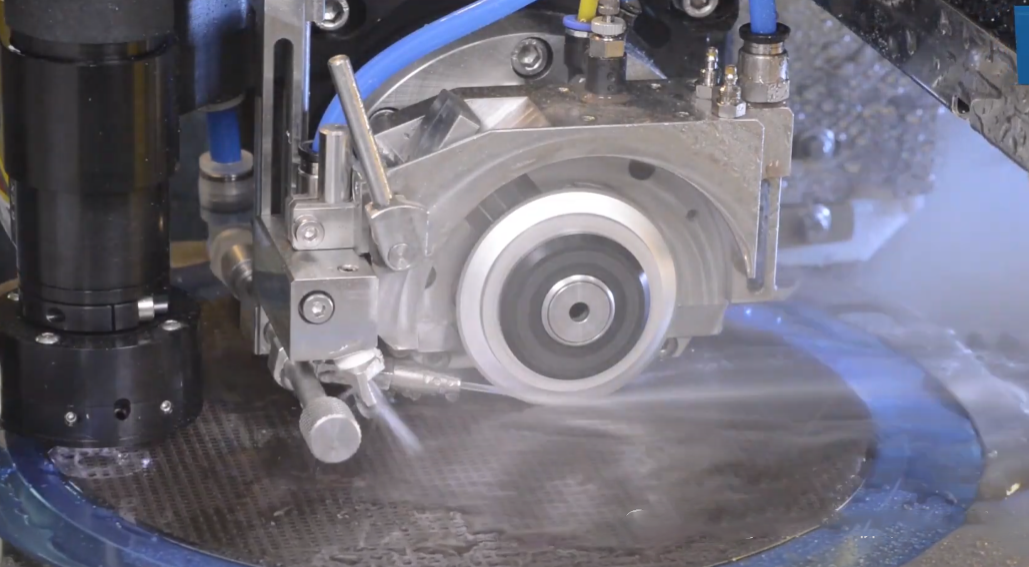
การขีดเขียนด้วยเครื่องจักรคือการใช้ใบมีดเพชรในการตัดเวเฟอร์ ซึ่งเป็นวิธีการขีดเขียนแบบดั้งเดิมและใช้กันทั่วไปที่สุด ใบมีดเพชรจะหมุนด้วยความเร็วสูงเพื่อตัดเวเฟอร์ และความร้อนและเศษต่างๆ ที่เกิดขึ้นจะถูกพัดพาไปกับน้ำ
ข้อดี:
1.อุปกรณ์มีราคาถูก
2. เหมาะสำหรับวัสดุเวเฟอร์ต่างๆ
ข้อเสีย:
1. ความแม่นยำในการจารึกไม่สูง
2. อัตราการเขียนต่ำ
3. มีแนวโน้มที่จะเกิดการแตกของขอบและความผิดปกติอื่นๆ
4. ไม่เหมาะสำหรับเวเฟอร์ที่บางเกินไป โดยทั่วไปเวเฟอร์ที่มีความหนาเกิน 100 ไมโครเมตรจะเหมาะสำหรับการขีดเขียนเชิงกล
การตัดด้วยเลเซอร์
เวเฟอร์บางชนิดเปราะและบางได้ค่อนข้างมาก ดังนั้นจึงมักเกิดปัญหาขอบและแตกร้าวจากใบมีดเพชร ดังนั้นจึงต้องพิจารณาการตัดด้วยเลเซอร์
การตัดด้วยเลเซอร์แบบ Stealth Dicing เป็นกระบวนการสองขั้นตอน:
ขั้นตอนแรกคือการใช้ลำแสงเลเซอร์เพื่อโฟกัสไปที่ด้านในของเวเฟอร์ โดยควบคุมความลึกของการโฟกัสของเลเซอร์อย่างแม่นยำ โดยทำให้เกิดรอยแตกเล็กๆ ภายในเวเฟอร์ ขณะที่พื้นผิวยังคงเหมือนเดิม
ขั้นตอนที่สองคือการยืดเทปที่ติดอยู่ด้านหลังเวเฟอร์ให้สม่ำเสมอด้วยเครื่องจักร เมื่อเทปขยายตัว ชิปแต่ละชิ้นบนเวเฟอร์จะถูกแยกออกจากกันตามเส้นทางที่ตัดด้วยเลเซอร์ล่วงหน้า
การตัดด้วยเลเซอร์แบบเต็ม
การตัดด้วยเลเซอร์แบบเต็มรูปแบบหมายถึงการฉายลำแสงเลเซอร์โดยตรงบนพื้นผิวเวเฟอร์ตลอดทั้งความหนาของเวเฟอร์ ตัดเวเฟอร์ทั้งหมด และแยกชิปตัวเดียวโดยตรง การตัดด้วยเลเซอร์แบบเต็มรูปแบบช่วยให้ควบคุมกำลังเลเซอร์ โฟกัส และความเร็วได้อย่างแม่นยำ เพื่อให้เหมาะกับวัสดุและความต้องการความหนาที่แตกต่างกัน ซึ่งแตกต่างจากการตัดด้วยเลเซอร์แบบเข้ารหัส การตัดด้วยเลเซอร์แบบเต็มรูปแบบไม่จำเป็นต้องมีขั้นตอนการขยายเทปตามมาเพื่อแยกชิป
ข้อดีของการตัดด้วยเลเซอร์?
1. อัตราการเขียนเร็วมาก
2. ความเสียหายจากความเครียดมีน้อย
3. ความแม่นยำในการเขียนสูงมาก
ข้อเสีย :
1.ราคาแพง
2. เศษซากที่เกิดจากการเผาเลเซอร์ทำความสะอาดได้ยาก
Slotted Scribe คืออะไร?
เพื่อลดปัญหาขอบของการขีดเขียน คุณสามารถใช้เลเซอร์เจาะร่องก่อน จากนั้นจึงใช้ใบมีดเพชรในการขีดเขียน นอกจากนี้ยังสามารถใช้ใบมีดเพชรที่หนากว่าเจาะร่องแล้วจึงตัดด้วยใบมีดเพชรได้อีกด้วย
กระบวนการ DBG คืออะไร?
กระบวนการ DBG (Dicing Before Grinding) ที่เป็นเอกสิทธิ์เฉพาะของบริษัท Japan Disco หมายถึงการเจียรส่วนหน้าของเวเฟอร์ให้ได้ตามความลึกที่กำหนด (ไม่ตัดผ่านเวเฟอร์) จากนั้นจึงเจียรด้านหลังของเวเฟอร์ให้ได้ตามความลึกในการตัดที่สอดคล้องกัน เพื่อลดปัญหาการแตกร้าวของเวเฟอร์
Fountyl Technologies PTE Ltd มุ่งเน้นไปที่อุตสาหกรรมการผลิตเซมิคอนดักเตอร์ ผลิตภัณฑ์หลัก ได้แก่ หัวจับพิน หัวจับเซรามิกที่มีรูพรุน เอฟเฟกเตอร์ปลายเซรามิก คานสี่เหลี่ยมเซรามิก แกนหมุนเซรามิก ยินดีต้อนรับการติดต่อและเจรจาต่อรอง!












